半導体装置の品質
2012.12.15 Quality of Wafers in Semiconductor Devices


半導体装置の品質
半導体デバイス製造では、ウェハーは微小な傷もなく均一にフラットであることが重要です。 しかし、そのような品質にするのは難しく、CMP(chemical mechanical planarization)と呼ばれる精巧な研磨処理が必要となります。(図1を参照ください。):
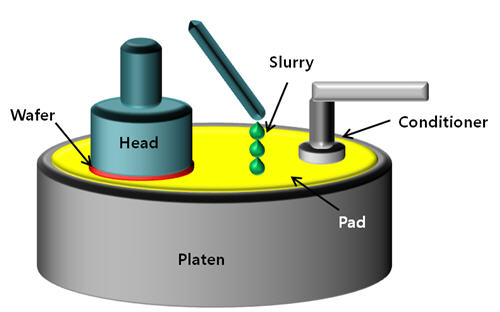
図1 CMPの概略図
科学者や工学者は、スクラップになってしまうウェハーの重大な欠陥となるのが 研磨処理で微細な傷が生成されることであることは昔から気づいていることでした。 この現象を理解するために多くの努力が払われてきましたが、さらに深い検証が依然として必要とされています。
その文献は、マイクロスクラッチの主たる原因はスラリー(研磨剤の入った液)からの粒子が磨り動くことではなく、 研磨パッド内でせきとめられる粒子であること示す検証を示します。 この研究で粒子が水とパッドとどう相互に作用するかをシミュレートするために、ADINAが使われました。
そのシミュレーションは4つの部分に分かれます:ウエハー、粒子、パッド、そしてスラリーです。 流体?構造相互作用条件は、粒子、ウエハー、スラリー流体と接しているパッドに適用されました。
構造がパッド表面上で変化することで、粒子がパッドに完全に張り付くことをシュミレーションは明らかにしました。 次に、これがパッドの機械的な特性(剛 性や硬さ)や摩擦特性を変化させ、その結果、マイクロスクラッチとなります。 パッドと粒子が混合した状態は上の動画と図2のスナップ図に見ることができます。 ここでは、ソリッドモデル上の結果だけを示しています。 粒子の周りのスラリーの流れのス ナップ図は、図3に示します。
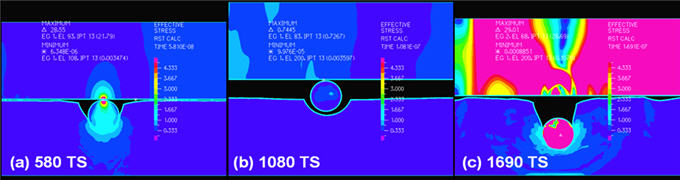
図2 パッドと粒子の混在状態の図(ウェハー、粒子、ポリエチレンパッド)

図3 スラリーの流れのスナップショット
またその研究はウエハーの不均一問題、ウエハーの準備中での他の致命的な弱点に取り組みました。 以前の研究ではほとんどの学者は、ウエハーとパッドの相互作用をシミュレートするためにマクロスケールモデル(粒子を含まない)を適用し、 ウェハー材料の研磨率を指標としてウェハーとパッドの間の接触圧を利用しました。 しかし実験テストで観察したように、材料の研磨率はウェハーの表面上の接触圧ではなく、研磨層の中の応力分布に直接関係があります。 マクロスケールの手法はウェハーの端における高い応力を予測せず、ウェハーの不均一問題を説明することができません。 だからマイクロスケールモデルが必要なのです。
文献は、詳細な粒子を表現し、流体-構造の相互作用の影響を考慮してモデル化しています。 二つのケースがシミュレートされていて、一つは動く粒子のケースでもう一つはパッドにくっ付いた粒子の計算です。 パッドにくっ付いた粒子の条件が実験データに良く合っていることがわかりました。下の動画を参照ください。

この研究は、ADINAの使い方がマルチフィジックスの影響を含む重要な物理現象を、見分けたり研究したりするのにどう役立てられるかについての一つの例です。 言うまでもなくADINAを使ったもしくは使っている方には、数値的に非常に価値の高い最近の研究です。
Reference
Keywords:
ウエハー、半導体、化学的機械的平坦化、流体?構造相互作用、マルチフィジックス、スラリー、研磨
協賛:
I.-H. Sung et al, Hannam University, Republic of Korea
